type
status
date
slug
summary
tags
category
Property
Jun 10, 2024 02:44 PM
icon
password
属性
属性 1
描述
Origin
URL
光刻机简介摩尔定律2006国际半导体技术路线图(ITRS)光刻机作用 光刻工艺流程 光刻机发展路线图 光刻机的构成总体构成汞灯光源激光器光源光刻机的工作原理总工作原理镜头光源分辨率套刻精度工艺节点曝光和显影过程曝光过程显影过程曝光过程中的技术整体流程光刻机产业链参考资料
光刻机简介
摩尔定律
Intel 创始人之一摩尔1964年提出,大约每隔12个月:
1). 芯片能力增加一倍、芯片价格降低一倍;
2). 广大用户的福音、行业人员的噩梦。
芯片集成密度不断提升、光刻分辨率的不断提升!

2006国际半导体技术路线图(ITRS)
原理研究-样机研发-产品量产-持续改进

光刻机作用
- 技术难度最高:光刻机集成了精密光学、机械工程、电子控制和材料科学等多个领域的先进技术,是微电子装备中技术难度最高的设备之一。
- 单台成本最大:由于其复杂性和技术密集度,光刻机的制造成本非常高,通常每台设备的价格可达数千万甚至数亿美元,是微电子生产设备中单台成本最大的。
- 决定集成密度:光刻机的分辨率和精度直接影响到芯片的集成密度,即单位面积内可集成的晶体管数量。更高的集成密度意味着更高的计算能力和更低的功耗。
- 源头中的龙头:光刻机不仅在微电子装备中占据龙头地位,更是整个半导体产业链的源头。没有先进的光刻机,就无法制造出高性能的芯片,进而影响到整个电子产业的发展。

光刻工艺流程

Lithography = Transfer the pattern of circuitry from a mask onto a wafer.

光刻机发展路线图


光刻机三巨头

光刻机的构成
总体构成
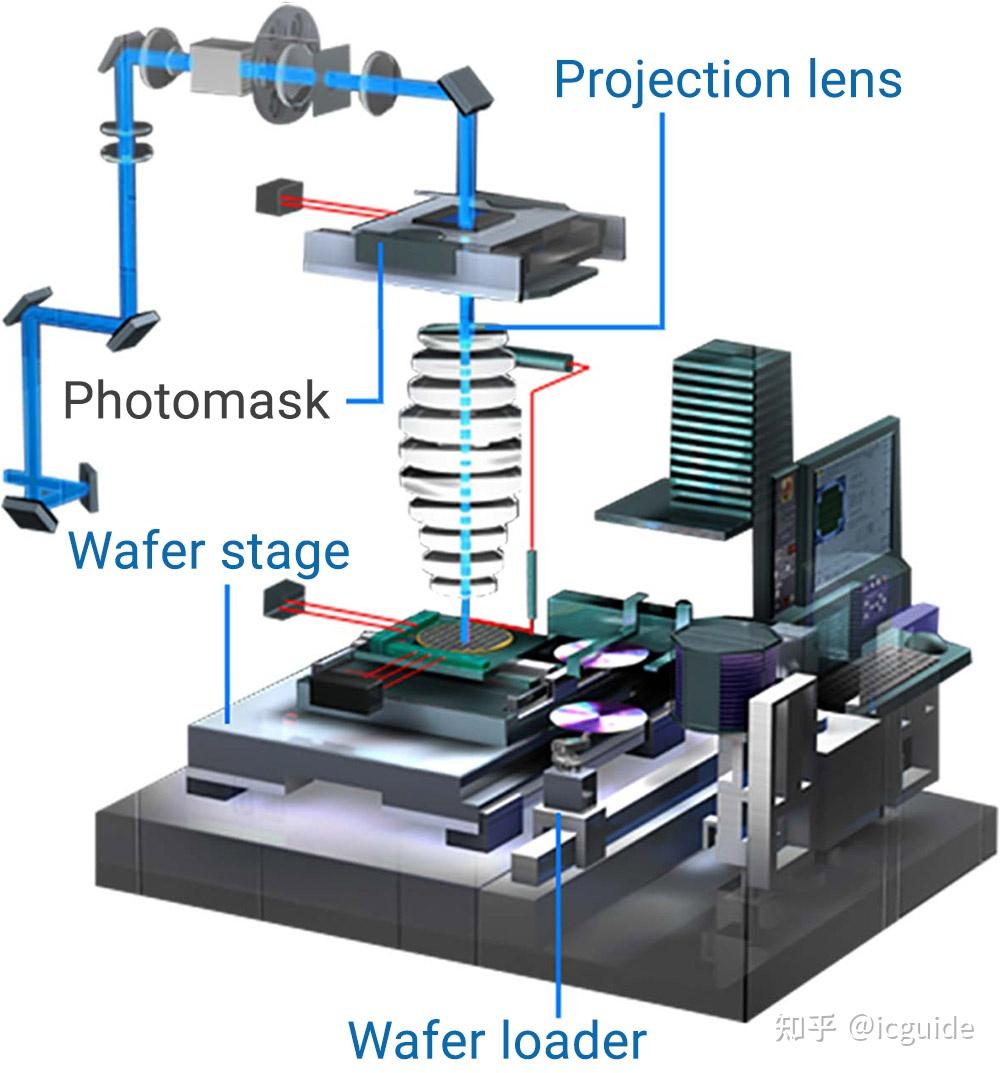
光刻机主要由以下几个部分组成:
光学系统:包括曝光光源、透镜、反射镜等,用于将掩模上的图形投影到硅片上。
机械系统:包括平台、运动控制系统、自动对位系统等,用于控制硅片的位置和运动轨迹。
控制系统:包括计算机、控制软件等,用于控制整个光刻机的运行和曝光过程。
汞灯光源
Projection lens(投影镜)
Operator Control Unit(操作控制单位)
Scanning Wafer Stage(扫描晶圆台)
illuminator(照明灯)
Lamp(晶片)
Wafer Transport System(晶圆输送系统)
Scanning Reticle Stage(扫描刻度台)

激光器光源



光刻机的工作原理
总工作原理
利用光刻机发出的光通过具有图形的光罩对涂有光刻胶的薄片曝光,光刻胶见光后会发生性质变化,从而使光罩上的图形复印到薄片上,从而使薄片具有电子线路图的作用。这就是光刻的作用,类似照相机照相。照相机拍摄的照片是印在底片上,而光刻刻的不是照片,而是电路图和其他电子元件。

简单点来说,光刻机就是放大的单反,光刻机就是将光罩上的设计好集成电路图形通过光线的曝光印到光感材料上,形成图形。

镜头
镜头是光刻机最核心的部分,采用的不是一般的镜头,可以达到高2米直径1米,甚至更大。光刻机的整个曝光光学系统,由数十块锅底大的镜片串联组成,其光学零件精度控制在几个纳米以内,目前光刻机镜头最强大的是老牌光学仪器公司德国蔡司,ASML用的就是他家的镜头。
由于绝大部分的光学材料对于13.5nm波长的极紫外光都有很强的吸收作用,所以EUV光刻机是别想着用透镜系统了,只能用反射镜。光源产生的光经过反射镜多次反射,投射在掩模上(EUV掩模也是反射式的),再被反射到晶圆表面。
EUV反射镜表面镀有Mo/Si多层膜结构,在Mo/Si最外层还有一层Ru,起到保护作用。Mo与Si的厚度不同,主要是考虑到这两种材料的反射系数不同。通过一定的厚度设计,可以实现光的相长干涉,从而达到最大的反射率。

为了满足0.5NA和0.75NA EUV光刻机的需求(现在的NA为0.33),ASML势必要在光源上下功夫,提升光源的输出功率。
光刻机的镜头和我们用的手机镜头或者相机镜头一样,需要定期擦一擦,保证良好的状态。虽然说光刻机的镜头是在真空环境下工作,但是光刻机内部不可能是绝对的真空,可能残留有水分和碳氢化合物。水能氧化Mo/Si膜,碳氢化合物会沉积在镜头表面形成碳膜。会导致反射率大幅降低,严重威胁到光刻机的使用寿命。
不过光刻机的镜组,可不能用袖子或者擦镜布去清洁(算了反正你们也碰不到)
要用化学方法清洗。比如说浓硫与双氧水的混合液(SPM),含有臭氧的水或者含有臭氧的双氧水溶液。
光源
光源是光刻机核心之一,光刻机的工艺能力首先取决于其光源的波长。下表是各类光刻机光源的具体参数:

最早光刻机的光源是采用汞灯产生的紫外光源(UV:UltravioletLight),从g-line一直发展到i-line,波长缩小到365nm,实际对应的分辨率大约在200nm以上。
随后,业界采用了准分子激光的深紫外光源(DUV:DeepUltravioletLight)。将波长进一步缩小到ArF的193nm。不过原本接下来打算采用的157nm的F2准分子激光上遇到了一系列技术障碍以后,ArF加浸入技术(ImmersionTechnology)成为了主流。
所谓浸入技术,就是让镜头和硅片之间的空间浸泡于液体之中。由于液体的折射率大于1,使得激光的实际波长会大幅度缩小。目前主流采用的纯净水的折射率为1.44,所以ArF加浸入技术实际等效的波长为193nm/1.44=134nm。从而实现更高的分辨率。F2准分子激光之所以没有得以发展的一个重大原因是,157nm波长的光线不能穿透纯净水,无法和浸入技术结合。所以,准分子激光光源只发展到了ArF。
这之后,业界开始采用极紫外光源(EUV:ExtremeUltravioletLight)来进一步提供更短波长的光源。目前主要采用的办法是将准分子激光照射在锡等靶材上,激发出13.5nm的光子,作为光刻机光源。目前,各大Foundry厂在7nm以下的最高端工艺上都会采用EUV光刻机,其中三星在7nm节点上就已经采用了。而目前只有荷兰ASML一家能够提供可供量产用的EUV光刻机。
目前EUV的光源主要有两种,分别是用放电产生的等离子体发射EUV(discharge-produced plasma,DPP)和用激光激发的等离子体来发射EUV(laser-produced plasma,LPP)
以LPP为例,使用激光照射材(Xe或者Sn)料激发等离子体,产生EUV。
Xe的缺点是转换效率低,只有1%左右。也就是说输入的能量只有1%产生13.5nm的EUV,其余的能量不是产生其他的波长的光(杂波),就是变成热能。
(转换效率,conversion efficiency,CE,定义为在13.5nm附近2%带宽内输出的能量与总能量的比值)
Xe效率低,且发热大,不能满足量产需求。因此目前的EUV多采用Sn作为工作材料。当然Li或许也能产生EUV。
分辨率
光刻机的分辨率(Resolution)表示光刻机能清晰投影最小图像的能力,是光刻机最重要的技术指标之一,决定了光刻机能够被应用于的工艺节点水平。但必须注意的是,虽然分辨率和光源波长有着密切关系,但两者并非是完全对应。具体而言二者关系公式是:

公式中R代表分辨率;λ代表光源波长;k1是工艺相关参数,一般多在0.25到0.4之间;NA(Numerical Aperture)被称作数值孔径,是光学镜头的一个重要指标,一般光刻机设备都会明确标注该指标的数值。
一定要确认该值。在光源波长不变的情况下,NA的大小直接决定和光刻机的实际分辨率,也等于决定了光刻机能够达到的最高的工艺节点。NA的大小与镜子尺寸成正相关。
要想缩小特征尺寸,要么减小波长,要么提高数值孔径。在EUV量产之前,DUV光源的波长从365nm到248nm,再到193nm,再到193nm浸润式(增加折射率,提高NA),配合双重光刻技术,一直将logic的器件尺寸推进到10nm级(例如Intel 10nm,台积电7nm,SMIC N+2)。
套刻精度
套刻精度(Overlay Accuracy)的基本含义时指前后两道光刻工序之间彼此图形的对准精度(3σ),如果对准的偏差过大,就会直接影响产品的良率。对于高阶的光刻机,一般设备供应商就套刻精度会提供两个数值,一种是单机自身的两次套刻误差,另一种是两台设备(不同设备)间的套刻误差。
套刻精度其实是光刻机的另一个非常重要的技术指标,不过有时非专业人士在研究学习光刻机性能时会容易忽略。我们在后面的各大供应商产品详细列表里,特意加上了这个指标。
工艺节点
工艺节点(nodes)是反映集成电路技术工艺水平最直接的参数。
目前主流的节点为0.35um、0.25um、0.18um、90nm、65nm、40nm、28nm、20nm、16/14nm、10nm、7nm等。传统上(在28nm节点以前),节点的数值一般指MOS管栅极的最小长度(gatelength),也有用第二层金属层(M2)走线的最小间距(pitch)作为节点指标的。
节点的尺寸数值基本上和晶体管的长宽成正比关系,每一个节点基本上是前一个节点的0.7倍。这样以来,由于0.7X0.7=0.49,所以每一代工艺节点上晶体管的面积都比上一代小大约一半,也就是说单位面积上的晶体管数量翻了一番。这也是著名的摩尔定律(Moore'sLaw)的基础所在。一般而言,大约18~24个月,工艺节点就会发展一代。
但是到了28nm之后的工艺,节点的数值变得有些混乱。一些Foundry厂可能是出于商业宣传的考量,故意用一些图形的特征尺寸(FeatureSize)来表示工艺节点,他们往往用最致密周期图形的半间距长度来作为工艺节点的数值。这样一来,虽然工艺节点的发展依然是按照0.7倍的规律前进,但实际上晶体管的面积以及电性能的提升则远远落后于节点数值变化。更为麻烦的是,不同Foundry的工艺节点换算方法不一,这便导致了很多理解上的混乱。根据英特尔的数据,他们20nm工艺的实际性能就已经相当于三星的14nm和台积电的16nm工艺了。
从英特尔公布的10nm节点详细工艺参数看到,同样10nm工艺节点上,英特尔的晶体管密度大约是三星和台积电的两倍。
在65nm工艺及以前,工艺节点的数值几乎和光刻机的最高分辨率是一致的。由于镜头NA的指标没有太大的变化,所以工艺节点的水平主要由光源的波长所决定。ArF193nm的波长可以实现的最高工艺节点就是65nm。
而到了65nm以后,由于光源波长难于进一步突破,业界采用了浸入式技术,将等效的光源波长缩小到了134nm。不仅如此,在液体中镜头的NA参数也有了较大的突破。根据ASML产品数据信息,采用浸入技术之后,NA值由0.50–0.93发展到了0.85–1.35,从而进一步提高了分辨率。同时,在相移掩模(Phase-ShiftMask)和OPC(
OpticalProximityCorrection)等技术的协同助力之下,在光刻设备的光源不变的条件下,业界将工艺节点一直推进到了28nm。
而到了28nm以后,由于单次曝光的图形间距已经无法进一步提升,所以业界开始广泛采用MultiplePatterning的技术来提高图形密度,也就是利用多次曝光和刻蚀的办法来产生更致密图形。
值得特别注意的是,MultiplePatterning技术的引入导致了掩模(Mask)和生产工序的增加,直接导致了成本的剧烈上升,同时给良率管理也带来一定的麻烦。同时由于前述的原因,节点的提升并没有带来芯片性能成比例的增加,所以目前只有那些对芯片性能和功耗有着极端要求的产品才会采用这些高阶工艺节点技术。于是,28nm便成为了工艺节点的一个重要的分水岭,它和下一代工艺之间在性价比上有着巨大的差别。大量不需要特别高性能,而对成本敏感的产品(比如IOT领域的芯片)会长期对28nm工艺有着需求。所以28nm节点会成为一个所谓的长节点,在未来比较长的一段时间里都会被广泛应用,其淘汰的时间也会远远慢于其它工艺节点。
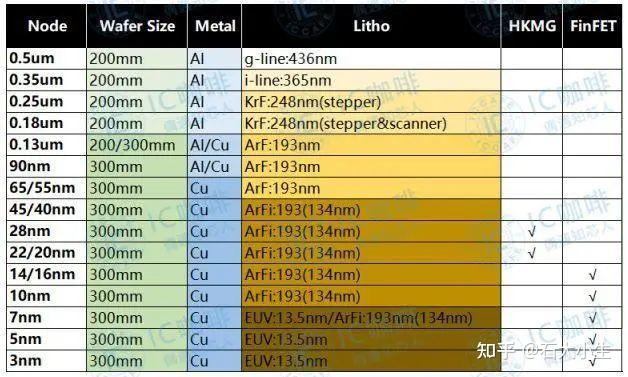
各个工艺节点和工艺及光刻机光源类型的关系图
根据业界的实际情况,英特尔和台积电一直到7nm工艺节点都依然使用浸入式ArF的光刻设备。但是对于下一代的工艺,则必须采用EUV光源的设备了。目前全球只有ASML一家能够提供波长为13.5nm的EUV光刻设备。毫无疑问,未来5nm和3nm的工艺,必然是EUV一家的天下。事实上,三星在7nm节点上便已经采用了EUV光刻设备,而中芯国际最近也订购了一台EUV用于7nm工艺的研发。

在售的部分光刻机的列表及相关参数
目前光刻设备按照曝光方式分为Stepper和Scanner两种。Stepper是传统的一次性将整个区域进行曝光;而Scanner是镜头沿Y方向的一个细长空间曝光,硅片和掩模同时沿X方向移动经过曝光区动态完成整个区域的曝光。和Stepper相比,Scanner不仅图像畸变小、一致性高,而且曝光速度也更快。所以目前主流光刻机都是Scanner,只有部分老式设备依旧是Stepper。上表中如果没有特别注明,都是属于Scanner类型。
曝光和显影过程
曝光过程
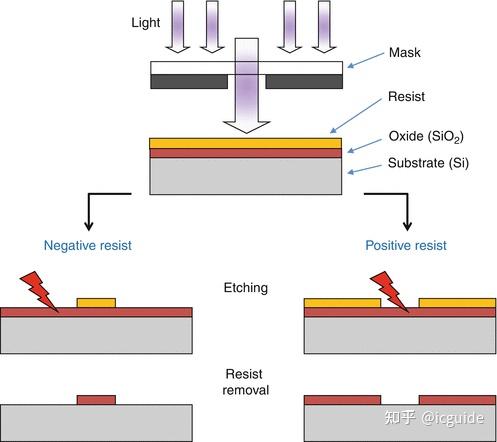
光刻机曝光过程
曝光过程是指将掩模上的图形通过光学系统投影到硅片上的过程。曝光过程主要包括以下几个步骤:
(1)准备工作:将硅片放置在平台上,并通过自动对位系统对硅片进行定位和对位。
(2)加热处理:将硅片加热至一定温度,以使其表面更容易吸收光线。
(3)涂覆光刻胶:将光刻胶涂覆在硅片表面,以形成一个光刻胶层。
(4)对位:通过自动对位系统将掩模和硅片对位,以确保图形的正确投影。
(5)曝光:通过光学系统将掩模上的图形投影到硅片上,并使用紫外线照射硅片表面,使其形成微小的结构。
显影过程
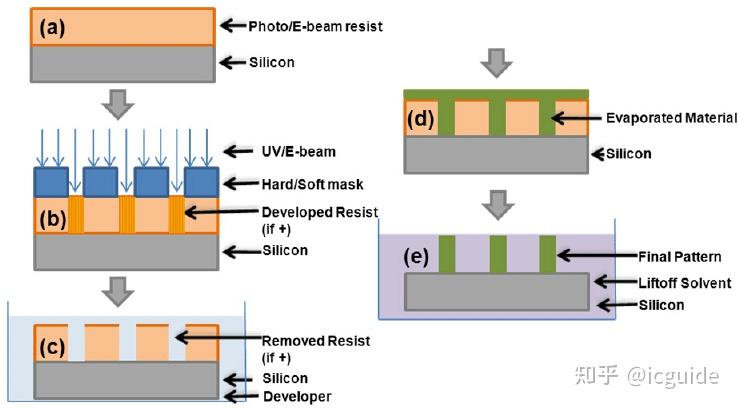
显影过程
显影过程是指将硅片表面的光刻胶进行化学反应,从而形成微小结构的过程。显影过程主要包括以下几个步骤:
(1)涂覆显影剂:将显影剂涂覆在硅片表面,以溶解光刻胶。
(2)显影:通过化学反应将硅片表面的光刻胶进行溶解,从而形成微小的结构。
(3)清洗:将硅片表面的显影剂和光刻胶残留物清洗干净,以准备下一次曝光。
曝光过程中的技术

整体流程
曝光过程中的技术主要包括以下几个方面:
光源技术:光源是曝光过程中最关键的部分,它的稳定性和光强度对于曝光的精度和速度都有着重要的影响。现代光刻机使用的光源主要有氙气灯、荧光灯、激光等。
透镜技术:透镜是将掩模上的图形投影到硅片上的关键部件,它的制造精度和材料质量对于曝光的精度和分辨率都有着重要的影响。
控制系统技术:控制系统是光刻机的核心部分,它负责整个曝光过程的控制和管理。现代控制系统采用计算机和控制软件,能够实现自动对位、自动曝光、自动对焦等功能。
曝光技术:曝光技术是光刻机制造中最关键的技术之一,它的精度和速度直接影响到芯片的制造质量和效率。现代曝光技术主要包括多重图形投射式曝光技术、极紫外光曝光技术等。
光刻机产业链
光刻机产业链

ASML产业链
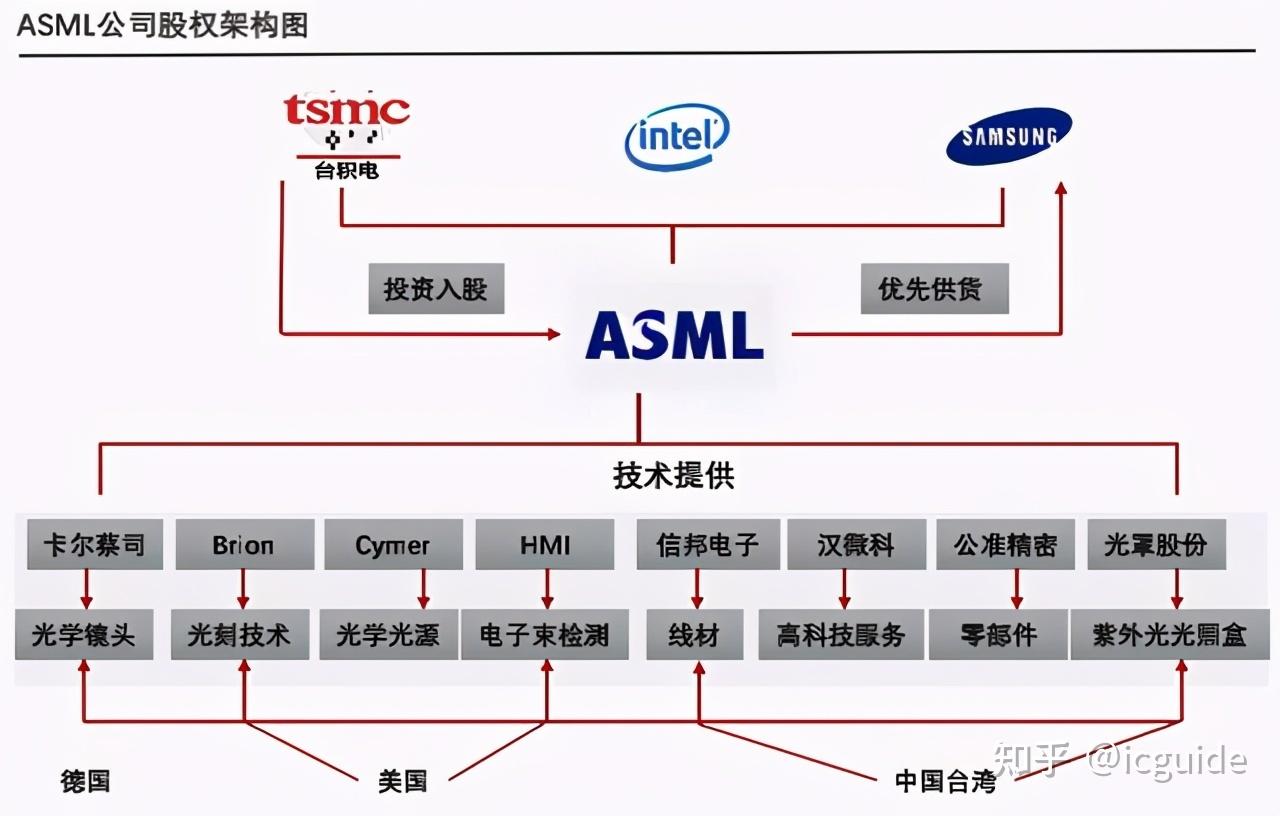
日本光刻机产业链
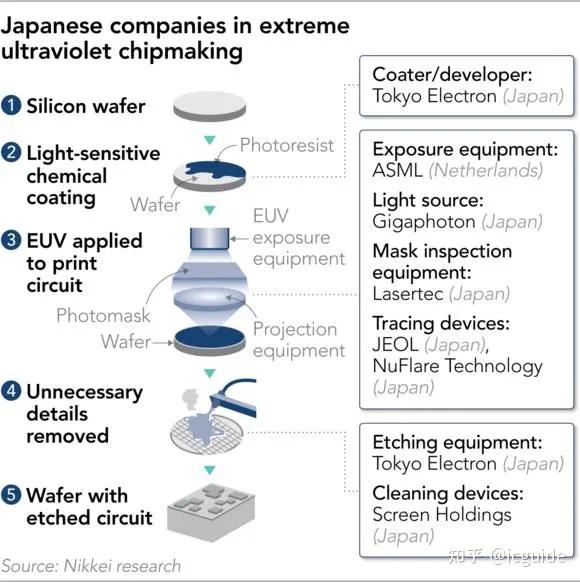
参考资料
实验结果证明,反射率最大值大约为70%。图示的光学系统由6个反射镜组成,因此透光率就只有0.7的6次方,大概是11.76%。增加反射镜的数目,可以提高光刻机的NA;但是相应的,透光率也要大打折扣。

- 作者:Conor
- 链接:https://www.xzhh.top/article/Lithography-machine
- 声明:本文采用 CC BY-NC-SA 4.0 许可协议,转载请注明出处。